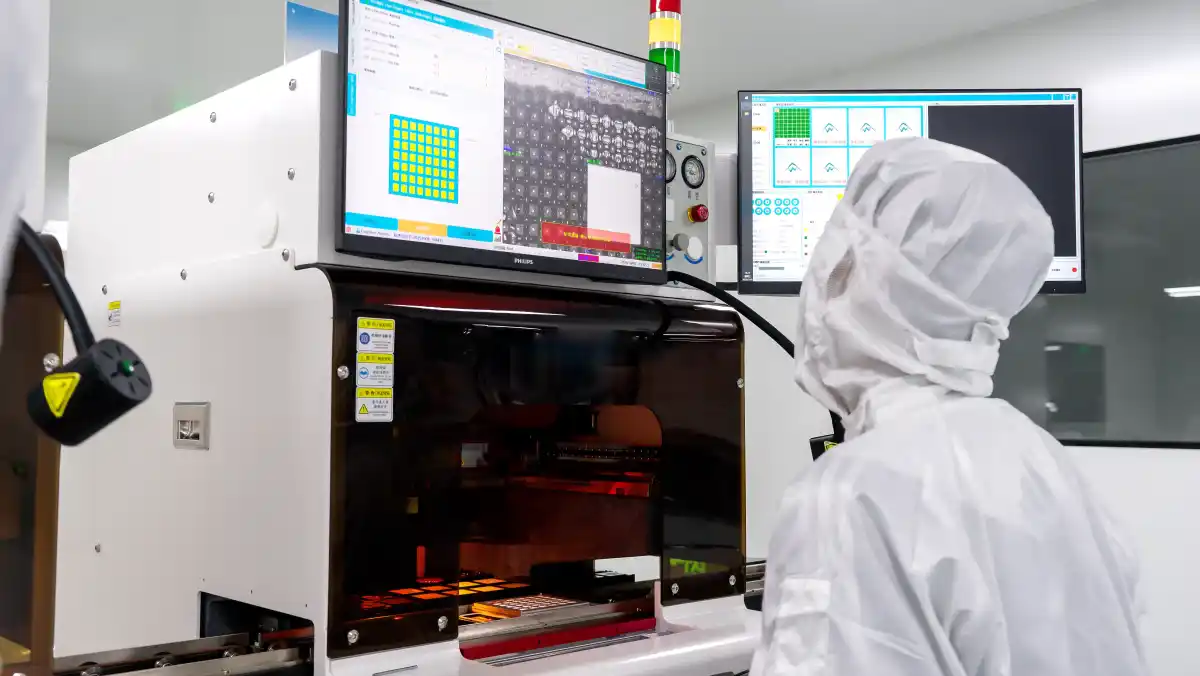
Via-технологии
Сквозные, глухие, скрытые переходные отверстия. Microvias, via-in-pad, stacked и staggered vias. Все технологии для HDI и многослойных ПП.
Переходные отверстия (vias) — ключевой элемент многослойных ПП, обеспечивающий электрическое соединение между слоями. Выбор типа via определяет плотность трассировки, сигнальную целостность, тепловые характеристики и стоимость платы.
JM electronic располагает полным арсеналом via-технологий: от стандартных сквозных отверстий до any-layer HDI со стекированными микропереходами. Наше оборудование включает CO2 и UV лазеры для формирования microvias, линии copper fill для заполнения via, оборудование для sequential lamination до 6 циклов.
Мы производим ПП с любой комбинацией via-типов: через-all + blind, buried + microvias, via-in-pad с copper fill. Каждый проект проходит DFM-анализ для оптимизации via-структуры с точки зрения надёжности и стоимости.
Типы переходных отверстий
Сквозные переходные отверстия (Through-Hole Via)
Классический тип via, проходящий через всю толщину ПП. Используется в стандартных многослойных платах. Простая технология, низкая стоимость. Ограничение: занимает место на всех слоях, что снижает плотность трассировки во внутренних слоях.
Глухие переходные отверстия (Blind Via)
Соединяет наружный слой с одним или несколькими внутренними, не проходя через всю плату. Экономит место на противоположной стороне. Требует последовательного ламинирования (sequential lamination) или лазерного сверления. Увеличивает стоимость производства.
Скрытые переходные отверстия (Buried Via)
Соединяет два или более внутренних слоя, не выходя на наружные поверхности. Полностью скрыт внутри ПП. Максимальная экономия места на наружных слоях. Требует sequential lamination, что увеличивает стоимость и сроки.
Microvias (Микропереходные отверстия)
Миниатюрные via диаметром ≤ 0.15 мм, формируемые лазерным сверлением. Основа технологии HDI. Обеспечивают максимальную плотность межслойных соединений. Могут быть заполнены медью (filled microvias) для стекирования (stacking).
Via-in-Pad (Переходное отверстие в контактной площадке)
Via размещается непосредственно в SMD-контактной площадке компонента. Критически важно для BGA с малым шагом (< 0.8 мм). Требует заполнения via смолой (resin fill) или медью (copper fill) с последующей планаризацией (capping). Без заполнения — риск утечки припоя в via при пайке.
Stacked Vias (Стекированные via)
Несколько microvias, расположенных друг над другом, соединяющих 3+ слоя. Каждый уровень — отдельный microvia, заполненный медью. Обеспечивает вертикальное соединение через несколько build-up слоёв. Максимальная плотность, но высокая стоимость.
Staggered Vias (Ступенчатые via)
Microvias на соседних уровнях смещены относительно друг друга. Более простая технология по сравнению со stacked vias (не требуется copper fill каждого уровня). Позволяет соединять несколько build-up слоёв при более низкой стоимости.
Технические характеристики
| Мин. диаметр (механическое сверление) | 0.15 мм |
| Мин. диаметр (лазерное сверление) | 0.05 мм |
| Макс. aspect ratio (through-hole) | 12:1 |
| Макс. aspect ratio (microvia) | 1:1 |
| Via fill | Смола (resin), медь (copper), проводящая паста |
| Via capping (планаризация) | Медь + полировка (для via-in-pad) |
| Точность позиционирования | ±25 мкм (лазер), ±50 мкм (механическое) |
| HDI build-up | 1+N+1, 2+N+2, 3+N+3, any-layer |
| Тестирование | Электротест 100%, microslice (шлиф), SEM |
| Стандарты | IPC-6012 Class II/III, IPC-2221/2222 |
Нужна HDI-плата со сложными via?
Отправьте Gerber-файлы — мы проведём DFM-анализ и предложим оптимальную via-структуру.