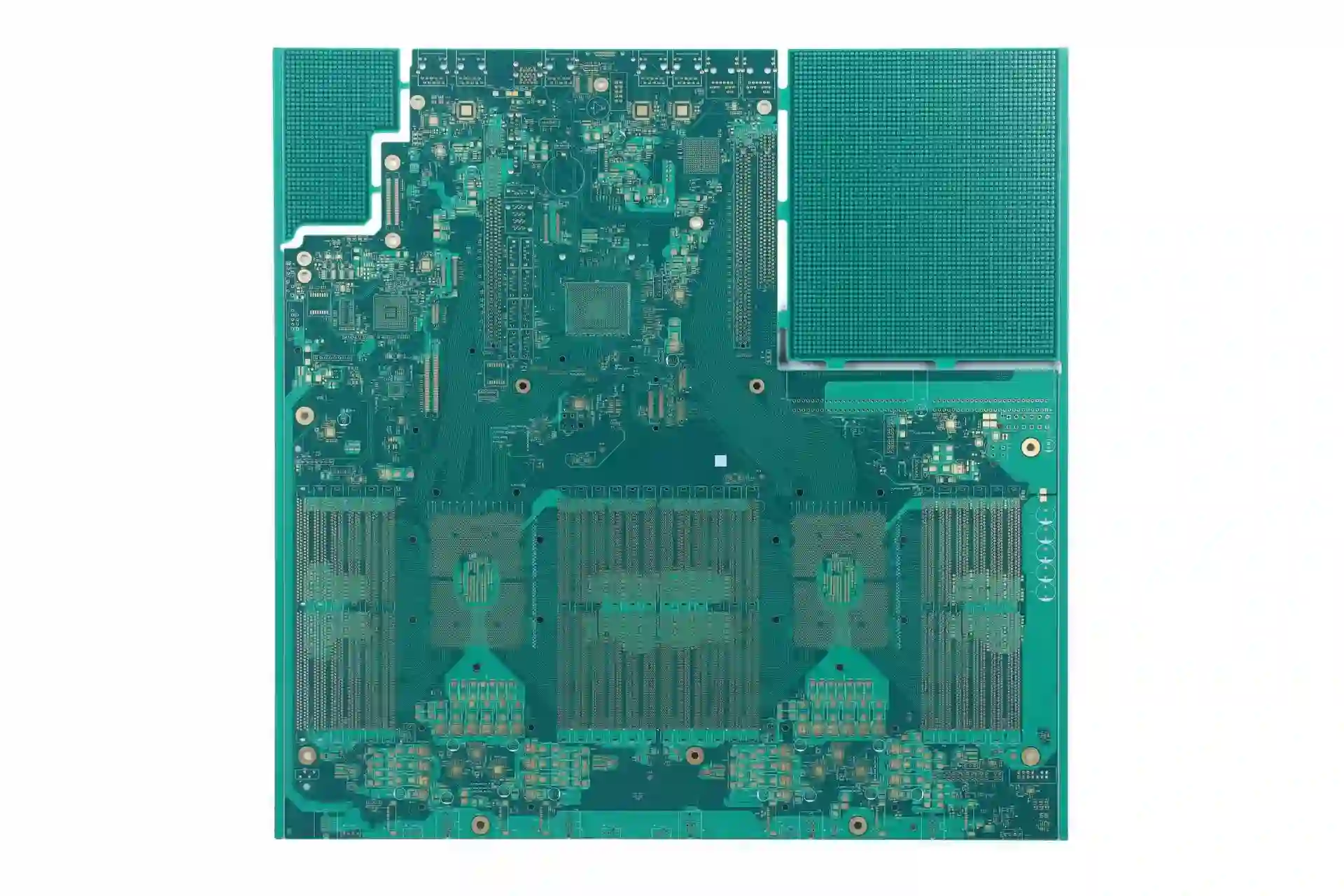
Производство HDI печатных плат (HDI PCB Manufacturing)
HDI ПП с лазерными микровиа от 0.075 мм, линия/зазор 0.075/0.075 мм, сборка 1+N+1 до 3+N+3, импеданс ±5%, от 1 шт., от 3 рабочих дней, IPC-6012 Class III
JM electronic производит HDI печатные платы на заводе в Шицзячжуане с полным циклом контроля: от DFM-аудита Gerber-файлов до 100% электрического тестирования готовых плат. Производственная мощность — 15 000 м²/мес., сертификаты ISO 9001:2015, IATF 16949, UL E478384, что критично для заказчиков из автомобильной и медицинской отраслей, где требуется прослеживаемость каждой партии.
HDI (High Density Interconnect) — это не просто «плата с мелкими дорожками». Это технология послойной наращивания (build-up) с лазерными микровиа, которая позволяет разместить BGA-компоненты с шагом 0.4 мм и ниже на плате, где обычная сквозная виа съедает 3-4 контактных площадки. Разница в плотности монтажа: стандартная ПП с THT-виа — до 200 пинов/см², HDI с микровиа — до 500 пинов/см².
Заказывать HDI у нас целесообразно, когда проект упирается в ограничения трассировки: процессор с 0.4 мм pitch BGA, ограничение по габаритам корпуса, или необходимость импеданс-контроля на частотах выше 5 ГГц. Мы предлагаем все типы HDI-сборки — от 1+N+1 (однократный build-up) до 3+N+3 (трёхкратный), включая any-layer конструкцию с произвольными межслойными переходами.

Ключевые преимущества
Лазерные микровиа от 0.075 мм
CO₂-лазер формирует микровиа диаметром 0.075–0.20 мм с точностью позиционирования ±15 мкм. Для via-in-pad с заполнением медной пастой — диаметр от 0.10 мм, что позволяет использовать BGA с шагом 0.4 мм без отхода контактных площадок на сквозные отверстия.
Многоуровневая сборка до 3+N+3
Производим все типы HDI-сборки: 1+N+1, 2+N+2, 3+N+3, а также any-layer (ELIC — Every Layer Interconnection). При 2+N+2 допускаются штабелированные (stacked) микровиа с заполнением медью для надёжной межслойной связи. Максимальное количество слоёв — 24 при общей толщине платы до 3.2 мм.
Импеданс-контроль ±5%
Контролируемый импеданс полосковых и копланарных линий: одинарный/дифференциальный, точность ±5% (типовое значение ±7% у большинства производителей). Диапазон: 25–120 Ом. TDR-измерение на каждой плате для частот до 12 ГГц, что достаточно для PCIe Gen4, USB 3.2, 10GbE.
Линия/зазор 0.075/0.075 мм
Травление с разрешением 0.075/0.075 мм (3/3 мил) на внешних слоях и 0.10/0.10 мм на внутренних. Это на 40% плотнее стандарта 0.10/0.10 мм и позволяет трассировать между контактами QFN с шагом 0.4 мм без нарушения DRC.
Прототип от 3 рабочих дней
Срочное производство HDI прототипов 1+N+1 — от 3 дней, 2+N+2 — от 5 дней. Серийное производство — от 7 дней. Параллельный запуск DFM-анализа и подготовки фотошаблонов сокращает время на 1–2 дня по сравнению с последовательным процессом.
IPC-6012 Class III сертификация
Производство по IPC-6012 Class III для медицинского и аэрокосмического оборудования: анодная нить (CAF) — тест при 85°C/85% RH/100 В в течение 1000 ч, микровиа — термоциклирование −40…+125°C, 500 циклов. Каждая партия сопровождается отчётом о проверке сечения микровиа.
Технические характеристики HDI производства
| Мин. диаметр микровиа (лазер) | 0.075 мм (3 мил) |
| Макс. диаметр микровиа | 0.30 мм |
| Мин. линия / зазор (внешний слой) | 0.075 / 0.075 мм |
| Мин. линия / зазор (внутренний слой) | 0.10 / 0.10 мм |
| Типы HDI-сборки | 1+N+1, 2+N+2, 3+N+3, Any-Layer (ELIC) |
| Макс. количество слоёв | 24 (включая build-up слои) |
| Толщина платы | 0.4–3.2 мм |
| Толщина диэлектрика build-up | 0.05–0.10 мм (RCC / препрег) |
| Аспект-отношение микровиа | ≤ 1.0:1 (0.75:1 типово) |
| Импеданс-контроль | 25–120 Ом, точность ±5% |
| Заполнение via-in-pad | Медная паста / эпоксид + медная фольга |
| Мин. BGA-шаг для трассировки | 0.4 мм (с via-in-pad) |
| Материалы | FR-4 (TG170), Isola 370HR, Megtron 6, Rogers 4350B |
| Финишные покрытия | ENIG (ENIEP), ENEPIG, OSP, Immersion Tin, Hard Gold |
| Электрический тест | 100% Flying Probe / Fixture (IPC-9252) |
Процесс производства
DFM-анализ и подготовка фотошаблонов
Инженер проверяет Gerber-файлы на соответствие HDI-правилам: аспект-отношение микровиа ≤1:1, зазоры от микровиа до медных полигонов ≥0.10 мм, возможность заполнения via-in-pad. При обнаружении нарушений — отчёт с рекомендациями в течение 4 часов. Параллельно изготавливаются фотошаблоны с разрешением 8000 dpi.
Изготовление сердечника (core) и внутренних слоёв
Травление внутренних слоёв сердечника с разрешением 0.10/0.10 мм. Прессование сердечника с внутренними слоями при температуре 180°C и давлении 300 psi. AOI-проверка каждого внутреннего слоя на разрыв цепей и короткие замыкания перед прессованием.
Лазерное сверление микровиа
CO₂-лазер (длина волны 9.4 мкм) формирует микровиа в RCC-слое или препреге. Для сквозных отверстий — механическое сверло от 0.15 мм. Точность позиционирования ±15 мкм обеспечивается системой совмещения по базовым отверстиям. Скорость: до 300 микровиа/мин.
Металлизация и заполнение микровиа
Десмид-процесс (Desmear) очистки стенок микровиа, затем химическое меднение (0.3–0.5 мкм) и гальваническое наращивание до 20–25 мкм. Для via-in-pad — заполнение медной пастой с последующей планаризацией (снятие выступов ≤15 мкм) для обеспечения паяемости BGA-площадок.
Повторное ламинирование (build-up цикл)
Для 2+N+2 и выше — повторение цикла: наложение RCC-слоя → лазерное сверление → металлизация. Каждый build-up цикл добавляет один слой с микровиа сверху и снизу. При штабелированных микровиа — заполнение предыдущего уровня перед наложением следующего RCC-слоя. Контроль совмещения слоёв ±25 мкм.
Финишная обработка, тестирование и контроль
Нанесение финишного покрытия (ENIG: 3–5 мкм Ni / 0.03–0.05 мкм Au), нанесение паяльной маски (зелёная LPI, толщина 10–30 мкм), маркировка. 100% электрический тест (Flying Probe для прототипов, тестовая оснастка для серий). Микросечение 2–3 микровиа на панель для контроля качества металлизации по IPC-6012.
Области применения
Мобильные устройства и носимая электроника
- Смартфоны и планшеты (BGA 0.4 мм pitch)
- Носимые устройства (плата ≤30×30 мм)
- AR/VR-гарнитуры (6–10 слоёв HDI)
- Модули камер (any-layer HDI)
Телекоммуникации и сети
- Базовые станции 5G (HDI + Rogers 4350B)
- Серверные платы (импеданс ±5%, 10GbE)
- Оптические трансиверы (SFP, QSFP)
- Коммутаторы (BGA + микровиа 0.10 мм)
Автомобильная электроника
- ADAS-контроллеры (IATF 16949, Class III)
- Модули информационных систем
- Контроллеры BMS для EV
- Радарные модули 77 ГГц
Медицинское оборудование
- Портативные диагностические приборы
- Имплантируемые устройства (биосовместимые покрытия)
- УЗИ-аппараты (HDI + гибкая секция)
- Лабораторные анализаторы
Аэрокосмическая и оборонная техника
- Бортовые вычислители (термоциклы −55…+125°C)
- Системы навигации (GPS/ГЛОНАСС, импеданс-контроль)
- Радарные процессоры (any-layer HDI)
- Системы связи (СВЧ + HDI комбинированные)
IoT и промышленная автоматика
- Шлюзы IoT (HDI + RF-антенны на плате)
- Промышленные контроллеры ПЛК
- Модули беспроводной связи (Wi-Fi 6, BLE 5.0)
- Датчики с MEMS-BGA (0.4 мм pitch)
«Главная ошибка при заказе HDI — указать в Gerber микровиа 0.10 мм, не проверив аспект-отношение: если диэлектрик build-up 0.10 мм, то аспект 1:1 — на пределе воспроизводимости, брак по пустотам в металлизации доходит до 8%. Либо закладывайте диэлектрик 0.075 мм, либо микровиа 0.15 мм — и то, и другое мы можем изготовить, но цена и сроки отличаются. Присылайте файлы — за 4 часа скажем, какой вариант сработает.»
Часто задаваемые вопросы
Связанные услуги
Отрасли
Готовы обсудить ваш проект?
Отправьте Gerber-файлы и BOM — мы подготовим коммерческое предложение в течение 24 часов.